极紫外光刻(EUVL)技术是实现先进工艺制程的重要途径。LPP-EUV光源是当前极紫外光刻机采用的主流光源,其利用波长为10.6um的红外激光(IR)轰击Sn等离子体释放出EUV辐射,并通过收集镜将EUV辐射会聚到中间焦点(IF)处。冗余的红外辐射进入曝光光学系统会产生热负载,影响光刻系统稳定性和曝光图样质量,因此研究红外辐射抑制技术对保证光刻机性能至关重要。在EUV收集镜的表面集成光谱纯化滤波结构(Spectral Purity Filters, SPFs)可在一定程度上将红外辐射能量从EUV辐射中滤除,目前仅依赖衍射效率单一物理量评估红外辐射抑制效果。

图1 (a)集成SPFs的收集镜示意图,(b)中间焦点处孔径光阑表面的红外能量分布,(c)LPP-EUV系统光路示意图。
近日,中国科学院微电子研究所齐月静研究员团队针对集成SPF的EUV收集镜红外辐射抑制效果评估问题,提出了基于线性辐射通量密度的红外抑制比(Infrared Suppression Ratio, IRSR)理论模型,该模型可对收集镜红外辐射通量进行积分及降维映射,有效整合光源能量分布、收集镜几何面形、多层膜反射特性和光栅衍射效率等关键因素,实现了各因素对收集镜局部和全局IRSR贡献机制和定量权重的精确分析。较现有仅依赖衍射效率单一物理量的红外抑制效果评估方法,所提模型引入了多变量综合分析框架,证实了全局IRSR是局部IRSR的加权调和平均积分,其中权函数为收集镜表面线性辐射通量密度。该研究为收集镜和SPF协同优化及IRSR精密测量打下理论基础。
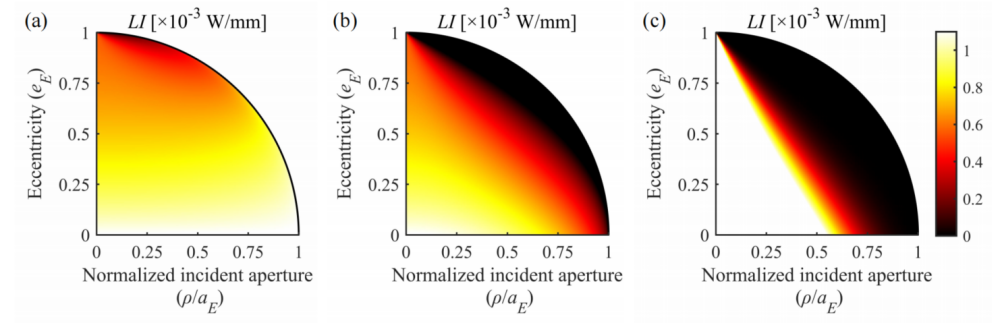
图2 在(a)均匀分布、(b)朗伯分布和(c)高斯分布的红外辐射源条件下,收集镜表面的线性辐射通量密度随归一化入射口径和椭圆率的变化。

图3 在(a)均匀分布、(b)朗伯分布和(c)高斯分布的红外辐射源条件下,入射与零级衍射的红外光沿收集镜子午方向的线性辐射通量微分。
基于本研究成果的论文“Modeling and evaluation for the infrared suppression ratio of an EUV collector with integrated spectral purity filters”发表于光学期刊《Optics Express》。微电子所博士生金浩为第一作者,齐月静研究员为通讯作者。此研究得到中国科学院战略先导科技专项(XDA0380000)的支持。
综合信息